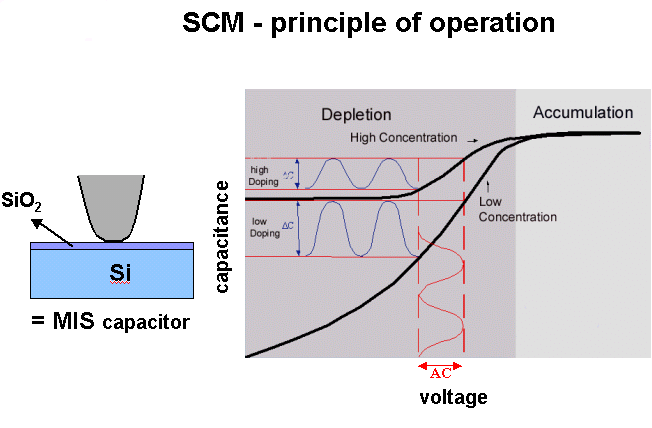
第8章
掃描式電容顯微鏡(SCM)
1. 原理
利用接觸式原子力顯微鏡掃描試片,但是卻使用金屬探針,如此可讓探針及試片上的氧化層形成一個MIS電容(圖8-1) ,並於探針加上一交流電壓,來檢測表面層之電容變化。
2.應用
半導體試片載子濃度,不同的載子濃度將會有不同的電容變化,而且利用擷取dC/dV的數據即可分辨出不同型態的載子分布(圖8-2),以及缺陷量測應用(圖8-3) ,對於半導體的檢測有極大的幫助。為掃描式探針顯微術最新應用之一
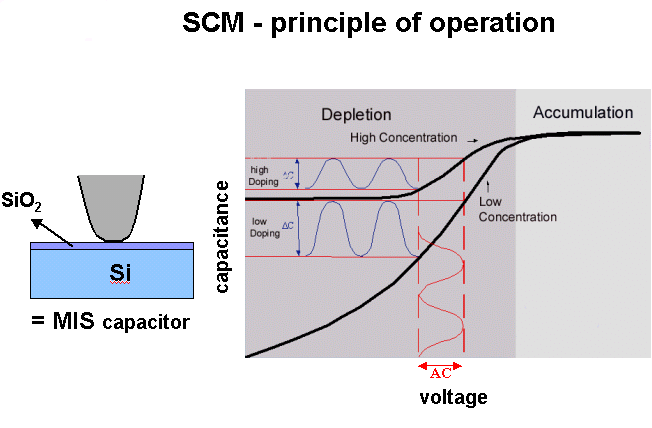
圖8-1掃描式電容顯微鏡之原理[1]

圖8-2 半導體之不同型態的載子分布[1]
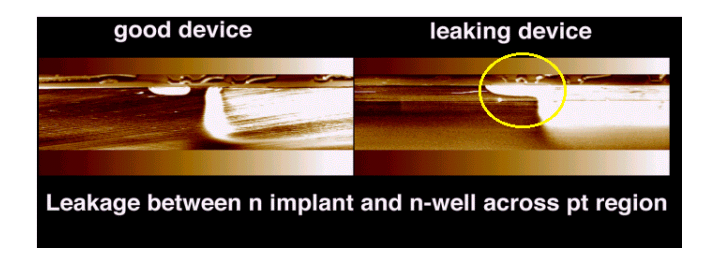
圖8-3 半導體之缺陷量測應用[1]